|
|
Nickel Application in Microelectronics
- Practical Electron Microscopy and Database -
- An Online Book -
|
|
https://www.globalsino.com/EM/
|
|
This book (Practical Electron Microscopy and Database) is a reference for TEM and SEM students, operators, engineers, technicians, managers, and researchers.
|
=================================================================================
Figure 2309 shows a failure of S-RAM cell induced by uncontrolled diffusion of Ni under a spacer. Note that the failing S-RAM cell was first localized on a wafer by the voltage-contrast method using scanning electron microscopy (SEM).
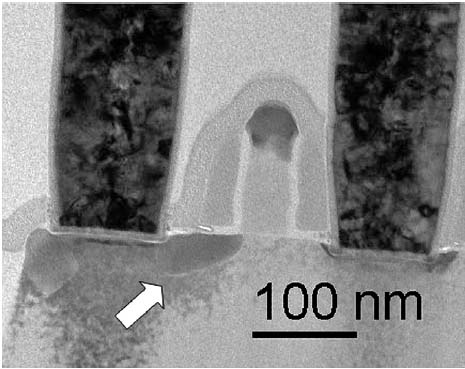
Figure 2309. TEM bright field image of a Ni encroachment (as indicated by the arrow) in an S-RAM cell.
[1]
[1] S. Pokrant, R. Pantel, M. Cheynet, Physical characterization by valence electron energy loss spectroscopy, 83 (11–12) 2364–2367 (2006).
|
=================================================================================
The book author (Dr Y. Liao) welcomes your comments, suggestions, and corrections, please click here for submission. You can click How to Cite This Book to cite this book. If you let Dr Y. Liao know once you have cited this book, the brief information of your publication will appear on the “Times Cited” page.
|
|