|
|
Beam Suppressor in FIB
- Practical Electron Microscopy and Database -
- An Online Book -
|
|
https://www.globalsino.com/EM/
|
|
This book (Practical Electron Microscopy and Database) is a reference for TEM and SEM students, operators, engineers, technicians, managers, and researchers.
|
=================================================================================
Figure 2488 shows the schematic illustration of dual beam FIB/SEM. The angle (α) between the electron beam and ion beam is normally in the range of 52 and 54°. The description and operation principle of all the components in the system can be found in the online book.
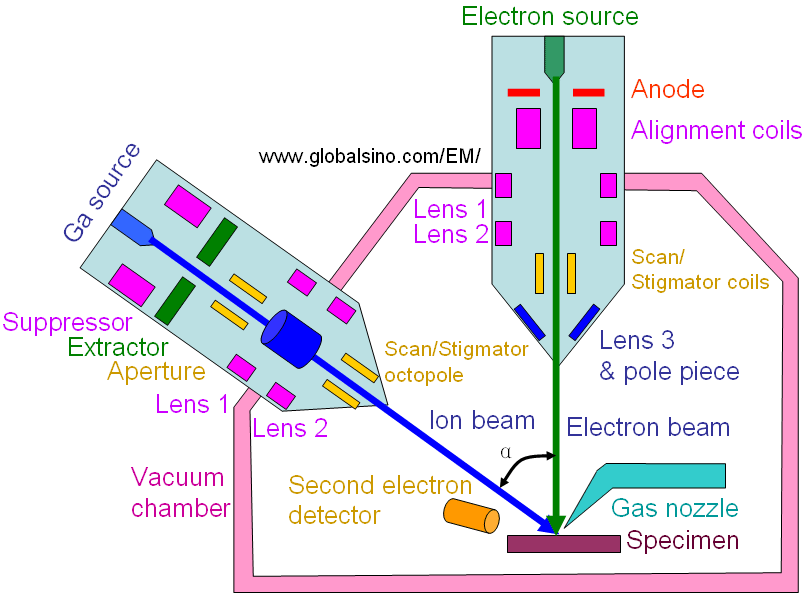
Figure 2488. Schematic illustration of dual beam FIB/SEM.
Table 2488. The function of each part in the FIB.
Part |
Function |
LMIS |
Ion source |
Suppressor |
Improves the distribution of extracted
ions |
Extractor |
High tension used for ion extraction: Typical accelerating voltage in FIB systems ranges from 1 to 30 keV |
Spray aperture |
First refinement |
1st lens (condenser lens) |
Parallelize the ion beam: probe forming |
Upper octopole |
Stigmator |
Beam defining aperture
|
Defines current: A set of apertures define the probe size and provides a range of ion currents (10 pA – 30 nA) |
Blanking deflector |
Beam blanking: Beam blankers are used to deflect the beam away from the centre of the column |
Blanking aperture |
Beam blanking |
Lower octopole |
Raster scanning |
2nd lens (objective lens) |
Beam focusing |
|
=================================================================================
The book author (Yougui Liao) welcomes your comments, suggestions, and corrections, please click here for submission. If you let book author know once you have cited this book, the brief information of your publication will appear on the “Times Cited” page.
|
|