| Table 994. TEM images of titanium silicides.
| Titanium silicides |
TEM images |
| Multiphases of Ti/Si |

Schematic formation multiphases in a Ti/Si sample [1] |
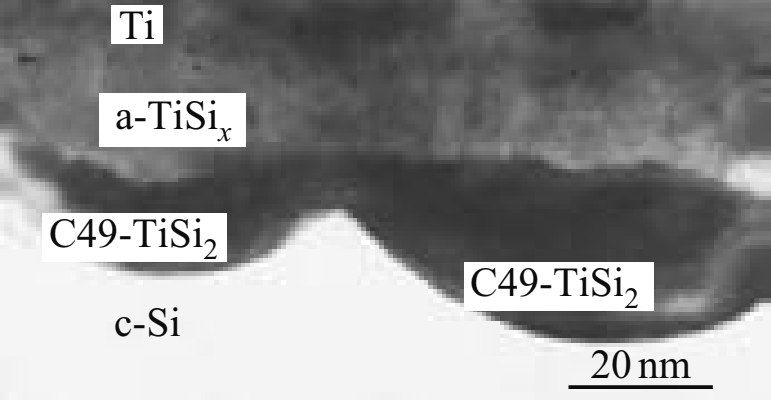
Growth of the metastable C49-TiSi2 at the interface of the Ti/poly-Si bilayer upon annealing at 10°C/min up to ~560°C [1] |
| TiSi2 |

The structure of TiSi2 C54 type is based on close packed MeSi2-layer sequences of ABCD. The B,C and D positions are the saddle point positions of the metal atoms of the next layer in alphabetical order. |
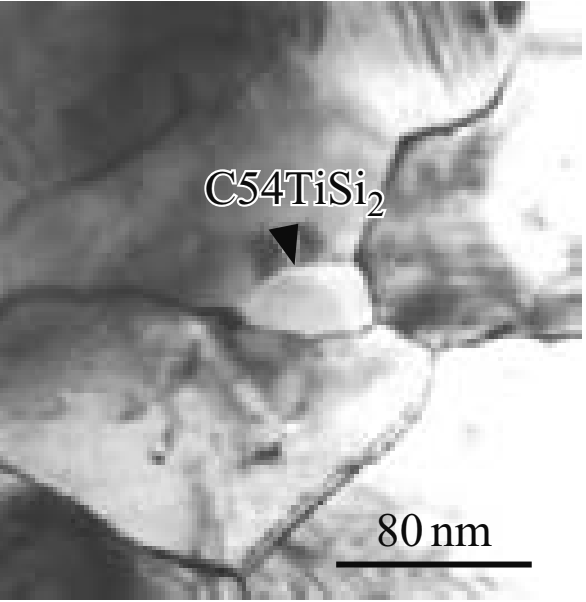
C54-TiSi2 nucleates at triple grain junctions (or grain boundaries) of the C49-TiSi2 disilicide thin films formed from
samples with 25 nm Ti. [2] C54 grain
grew at the expense of
many small C49 grains. |
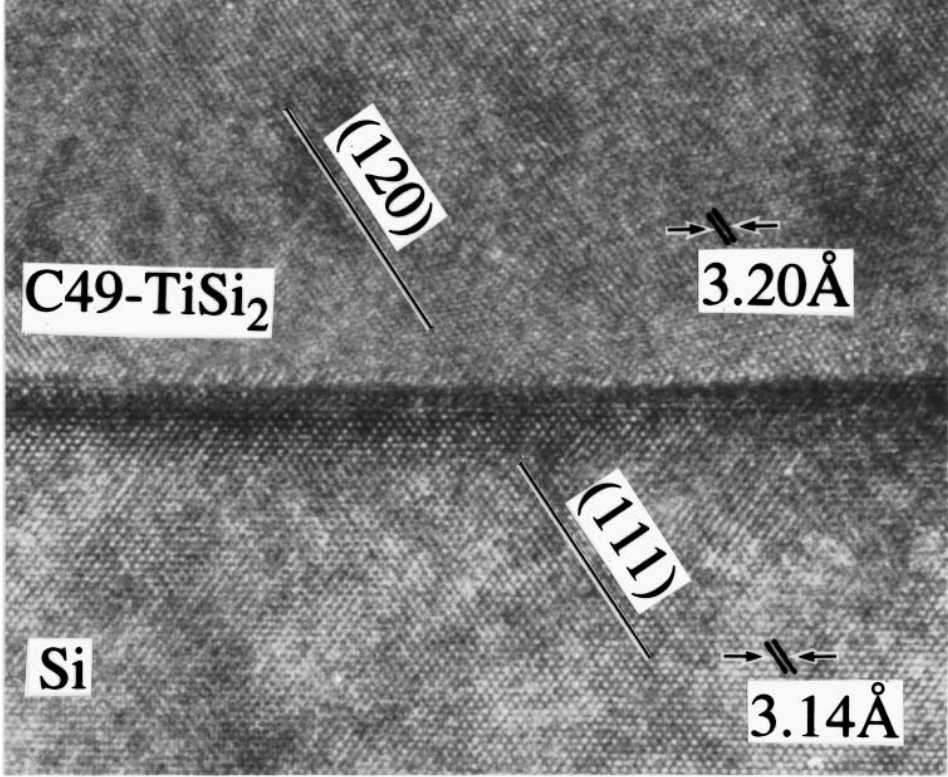
C49–TiSi2 is formed in 0.94 µm lines
[4] |
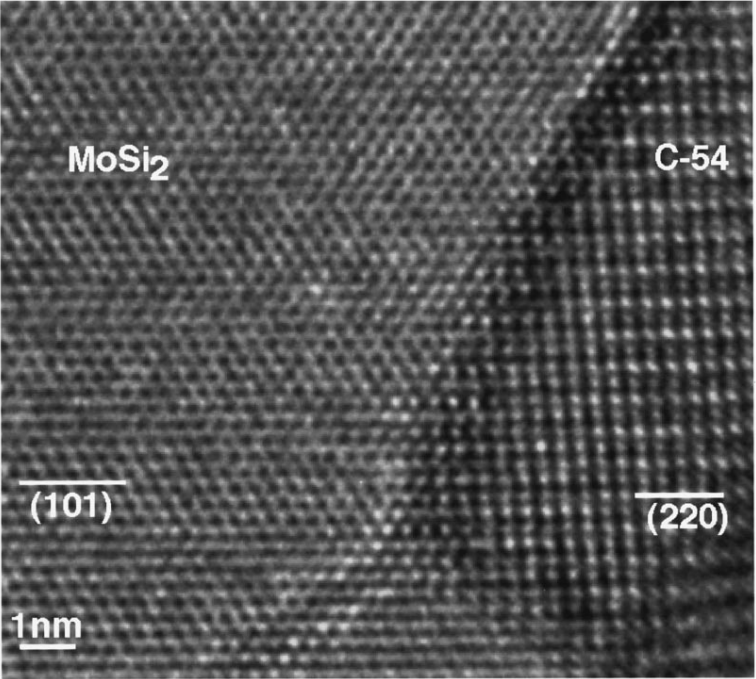
MoSi2 nucleated at the interface and acts
as a template for epitaxial growth of C54 TiSi2. [3] |

Defective C49-TiSi structure along [100] axis. The stacking faults in b direction are shown. The planes are often displaced by a vector 1/2(a+c). The defective nature of the
C49 phase is partially responsible for the high resistive behavior. [2] |
[1] Lih J. Chen, Silicide Technology for Integrated Circuits, 2004.
[2] Z. Ma, L.H. Allen, Kinetic mechanisms of the C49-to-C54 polymorphic transformation in titanium disilicide thin films: A microstructure-scaled nucleation-mode transition,
Phys. Rev. B, vol.49 (1994) p.13501–11.
[3] J. A. Kittl, M. A. Gribelyuk, and S. B. Samavedam, Mechanism of low temperature C54 TiSi2 formation bypassing
C49 TiSi2: Effect of Si microstructure and Mo impurities
on the Ti–Si reaction path, Applied Physics Letters, 73, 7, 900, 1998.
[4] Kaori Tai, Masao Okihara, Makiko Kageyama, Yusuke Harada, and Hiroshi Onoda, Effect of preamorphization implantation on C54–TiSi 2 formation in salicided narrow lines, Journal of Applied Physics, 85(6), 3132, 1999.
|
